EFEM 平台:高效、超潔淨、靈活的晶圓處理解決方案
支援次微米精度、高效震動隔離與多材質晶圓處理,實現極致潔淨與卓越性能的整合平台。
Averna EFEM 平台可根據您的應用需求進行客製化,以滿足潔淨度、處理技術、產能、以及外形規格 (Form Factor) 的要求,從設計到製造,此單一平台提供所需的硬體、軟體、影像、及光學設計、次微米計量 (Sub-Micron Metrology, 用於測量物體特徵尺寸、形狀或表面特性的技術,精度達到 1 µm 以下的範圍)、環境控制及材料處理,以應對不同的複雜性與精準度需求。
亮點
- 支援 1 至 4 個以上的 FOUP 或 SMIF 介面;
- 提供高精度晶圓對準功能及晶圓翻轉選項;
- 標準設計包含 3 軸與 4 軸機械手臂;
- 微環境設計可有效控制污染,並可選配氣態分子污染(AMC)過濾系統;
- 在成本與污染控制之間達到最佳平衡,符合 ISO 等級潔淨室的需求;
- 支援 300 mm、200 mm、150 mm 和 100 mm 圓形晶圓(亦可客製其他材料、形狀與尺寸);
- 可適應不同的晶圓技術,包括薄膜框架載體策略(film-frame carrier strategies)、太鼓晶圓(taiko wafers)、薄晶圓/厚晶圓、鍵合晶圓(bonded wafers)、非平坦晶圓/具有 3D 結構的晶圓,以及玻璃晶圓。
提供最佳結果的完整解決方案
Averna EFEM 平台既可作為標準 EFEM 使用,也可依據應用需求進行客製化,滿足潔淨度、處理技術、產能及外形規格的要求;從設計到製造,我們提供不同複雜度與精度的裝置,並能整合硬體、軟體、視覺系統、光學設計、次微米計量、環境控制與材料處理技術,以滿足從單一設備到多模組(最多 4 個設備並列配置)的生產設置。更快速推向市場
透過整合所有所需功能,我們大幅簡化了生產過程,確保產品無瑕疵;Averna 提供的選項包括:多種末端效應器技術:
- 伯努利效應(Bernoulli Effect)、邊緣夾持(Edge Grip)或真空夾持(Vacuum Grip);
- 靜電放電(ESD)充電控制選配;
- 真空處理與低污染整合能力;
- 可配置的佈局,簡化流程並/或優化空間佔用及外形規格;
- 高精度對準系統,精度可達 10 µm;
- 經驗豐富的震動隔離整合技術。
附加功能:視覺、光學與人工智慧專業
Averna 還提供光學與視覺系統設計功能,包括條碼讀取器(Barcode Readers)、光學字元識別(OCR)、缺陷分析與特徵化(Defect Analysis and Characterization)、污染檢測及平整度測量,可根據需求,整合額外的傳感技術,Averna 的內建預測可靠性分析軟體能持續進行系統監測與響應。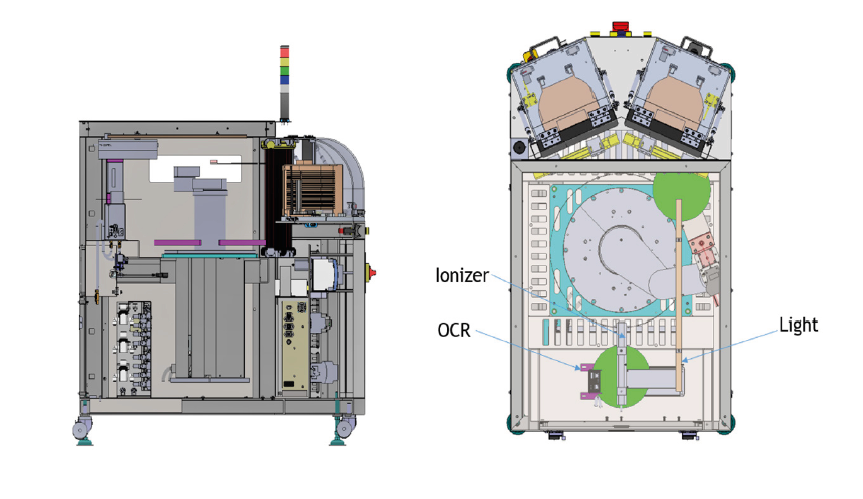 圖中為 Averna EFEM(Equipment Front End Module)的內部結構,包含晶圓傳輸系統、離子發生器(Ionizer)防靜電裝置、光學字元識別(OCR)系統和光源(Light),用於提供超潔淨環境、高效晶圓搬運及精準檢測功能。
圖中為 Averna EFEM(Equipment Front End Module)的內部結構,包含晶圓傳輸系統、離子發生器(Ionizer)防靜電裝置、光學字元識別(OCR)系統和光源(Light),用於提供超潔淨環境、高效晶圓搬運及精準檢測功能。
安全性、可靠性與 SEMI 標準合規
Averna EFEM 平台提供高平均故障間隔時間(MTBF)及穩定性能,符合 CE 和 SEMI 硬體與軟體標準,包括:- S2 和 S8:
為設備設計的環境、健康和安全(EHS)規範,涵蓋機械結構、電氣系統、化學使用和操作界面的安全性要求。 - E84 和 E87:
- E84 定義了自動化搬運系統中的傳感器通訊與物料移動協定,用於 FOUP(前開式統一載具)或 SMIF(標準機械介面)系統;
- E81規範自動化晶圓傳輸管理,包括批次識別、裝載和卸載晶圓的過程,提供對每批晶圓的追蹤與管理,確保搬運過程高效且準確。
- E58:
E58 標準主應用於晶圓批次的識別與管理,規範了晶圓批次標籤的設置與追蹤功能,包括條碼和 RFID(射頻識別)。
EFEM 平台功能一覽
關鍵功能
- 適應多樣晶圓技術:
提供靈活處理能力,支援現代半導體製造中多樣化的材料與結構需求;包括薄膜框架載體策略(film-frame carrier strategies)、太鼓晶圓(taiko wafers)、薄晶圓/厚晶圓、鍵合晶圓(bonded wafers)、非平坦晶圓/具有3D結構的晶圓,以及玻璃晶圓。 - 高平均故障間隔時間(MTBF):
平均故障間隔時間長,保證設備穩定運行,減少停機時間;提升生產效率和可靠性。 - 微環境(mini-environment)防止污染:
提供受控的局部空間,防止外部微粒或污染物進入關鍵區域;確保晶圓製程的高潔淨度,降低廢品率。 - 靜電放電(ESD)充電控制選項:
控制靜電產生,防止對晶圓及敏感元件造成損傷;尤其適合靜電敏感的半導體和電子元件製造。 - 真空及低污染整合能力:
支援真空處理和低污染操作,滿足精密製程需求。 - 可配置佈局:
簡化流程設計,優化空間使用和外形規格,適應不同生產線需求。 - 高精度對準系統:
精度達到 10 μm,確保晶圓對準的精確性;適用於多層電路對準與光刻製程。 - 整合震動隔離能力:
減少震動對設備運行和量測精度的影響。
環境控制
- 微環境(mini-environment)最高可達 ISO Class 1 操作:
空氣潔淨度達到 ISO Class 1 標準,是國際最高潔淨等級,保證每立方米空氣中粒子極少,避免污染影響製程,確保精密製程和高端材料的良率。 - 溫度控制:
維持恆定的製程溫度,避免熱膨脹或應力對產品品質的影響。 - 靜電電荷減少功能:
透過設備設計有效減少靜電積累。
晶圓處理
- 支援的晶圓尺寸:
300 mm、200 mm、150 mm、100 mm,滿足不同製程需求。 - 支援厚度及翹曲晶圓:
適用於各種表面特性和厚度的晶圓材料,包括玻璃、矽、碳化矽及鍺等基板。 - 夾持技術:
包括邊緣夾持、真空夾持、及伯努利效應(Bernoulli Effect)等多種技術,確保晶圓搬運穩定性;提高對不同類型晶圓(薄晶圓或翹曲晶圓)的處理效率與安全性。 - 晶圓翻轉功能:
自動翻轉晶圓,便於雙面處理。 - SMIF 和 FOUP 載入口:
支援 SMIF(標準機械介面)和 FOUP(前開式統一載具)兩種標準,載入口數量可配置為 1 至 4 個,適應不同產線配置。 - 支援高精度對準模組:
提供精確對準晶圓的附加功能,提升製程品質。
機械手臂(Robotics)
單臂或雙臂配置,支援 3 軸和 4 軸操作模式;靈活滿足不同製程自動化搬運需求。
視覺與光學
- 條碼讀取器(Barcode Readers):
自動識別晶圓標籤,便於批次追蹤與管理。 - 基準識別(Fiducial Recognition):
準確定位晶圓,支援對齊與校準。 - 光學字元識別(OCR):
讀取文字或標記,提升自動化處理能力。 - 缺陷分析與特徵化(Defect Analysis and Characterization):
檢測晶圓表面缺陷,確保製程品質。 - 平整度分析(Flatness Analysis):
檢測晶圓的平整度,特別是在敏感製程中。
軟體需求與功能
- SEMI 標準規範:
包括 300 mm 和 200 mm 晶圓的 SEMI 標準函式庫。 - 控制介面協定:
支援 SMEMA 和 SECS/GEM 協定,實現設備與主控系統的無縫連接。 - 資料管理與追蹤:
提供批次追蹤和資料分析功能,增強製程透明度。 - 晶圓映射(Wafer Mapping):
確保晶圓位置及狀態記錄精確,減少錯誤搬運風險。
Averna EFEM Platefrom Datasheet Download →